半个多世纪以来,半导体产业依循“摩尔定律”高歌猛进,但随着集成电路先进制程工艺不断微缩,距离物理极限越来越近,面临技术瓶颈;另一方面,人工智能、5G、自动驾驶等新兴产业蓬勃兴起,对算力芯片效能要求逐渐攀升,迎来多重挑战。
在此背景下,依托先进封装 (AP,Advanced Packing),实现“More than Moore”(超越摩尔),已成为产业巨头们角逐的关键所在。其中,2.5D先进封装作为在半导体产品由二维向三维发展进程中的一大技术亮点,通常用于高端ASIC、FPGA、GPU和内存立方体,前景广阔。
市场调研机构Yole预测,先进封装市场在2021~2027年间复合增长率将达到9.81%,到2027年市场规模将达到591亿美元;此外,2.5D/3D封装技术将实现显著增长,预计其复合增长率将达到13.73%,到2027年2.5D/3D封装市场规模预计将达180亿美元。
巨头“逐鹿”先进封装市场
先进封装格局急剧变动,台积电、英特尔和三星等行业巨头纷纷登场。
台积电作为领跑者,引领尖端先进封装平台的开发——2020年,台积电宣布将其2.5D/3D封装产品合并为一个全面的品牌“3DFabric”,由SoIC(系统整合芯片)、InFO(整合型扇出封装技术)、CoWoS(基板上芯片封装)所组成,进一步将制程工艺和封装技术深度整合。
尽管先进封装竞争激烈,巨头之间各有所长,但在ChatGPT横空出世,生成式AI红遍全球的大背景下,台积电CoWoS备受追捧。7月18日,台积电发声:“2025年CoWoS封装产能将较2024年翻倍,CoWoS封装产能在2025年将继续保持紧张。”
据悉,CoWoS是一种2.5D的整合生产技术,由CoW、oS组合而来:将芯片通过Chip on Wafer(CoW)的封装制程连接至硅晶圆,再把CoW芯片与基板(Substrate)连接,整合成CoWoS。该技术实现了提高系统性能、降低功耗、缩小封装尺寸的目标,从而也使台积电在后续的封装技术保持领先,为超越摩尔定律奠定了坚实基础。
英特尔方面则推出EMIB、Foveros和Co-EMIB等先进封装技术,力图通过2.5D、3D和埋入式三种异构集成形式实现互连带宽倍增与功耗减半的目标;三星电子紧追不舍,推出扇出型面板级封装(FOPLP)技术,以取得更高性价比。
近十年来,封装测试产业作为我国集成电路产业链中最具国际竞争力的环节,涌现了一大批优秀的封测企业。其中,天水华天科技股份有限公司(证券简称“华天科技”,证券代码:002185)作为全球前十的封测厂商,正持续提升核心业务技术含量,提高市场份额和盈利能力,技术水平及科研实力已处于国内同行业领先地位,向着先进封装技术“攀高向新”!
华天科技打造eSinC 2.5D平台
公开信息显示,华天科技在扩大和提升现有集成电路封装业务规模与水平的同时,大力发展SiP、FC、TSV、Fan-Out、WLP、2.5D、3D、Chiplet、FOPLP等先进封装技术和产品。尤其是面向2.5D先进封装赛道,华天科技致力打造eSinC(Embedded System in Chip)2.5D封装技术平台,以此迎接人工智能(AI)时代高端封测需求。
公开信息显示,华天科技eSinC 2.5D封装技术平台包含三大2.5D技术门类,分别是——硅转接板芯粒系统SiCS(Silicon interposer Chiplet System)、扇出芯粒系统FoCS(Fan out Chiplet System)和桥联芯粒系统BiCS(Bridge interconnection Chiplet System):
1.SiCS是采用硅转接板实现多芯粒互连的2.5D先进封装技术,这种结构通常具有高密度的I/O互连,适合高性能计算和大规模集成电路的需求,SiCS的优势在于其精密的制造工艺和优越的电性能。
 SiCS封装结构示意图
SiCS封装结构示意图2.FoCS利用重新布线层(RDL)作为中介层来实现芯片之间的互连,主要用于降低成本并适应不同类型的器件连接需求,具有更大的设计灵活性,能够支持更多的芯片连接FoCS 技术的关键特点包括:使用RDL中介层,由聚合物和铜线组成,具有相对较高的机械灵活性。
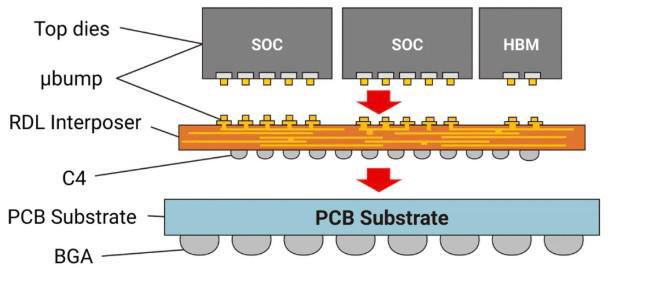 FoCS封装结构示意图
FoCS封装结构示意图3.BiCS关键特性包括:使用LSI芯片实现高密度的芯片间互连,这些芯片可以具有多种连接架构,并且可以重复用于多个产品,基于模具的中介层较宽的RDL层间距,并采用穿透中介层的通孔来实现信号和电力的低损耗高速传输,能够集成额外的元件。
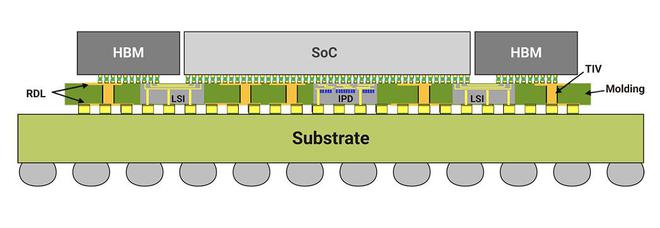 BiCS封装结构示意图
BiCS封装结构示意图值得一提的是,当前火爆的台积电CoWoS封装技术主要分为“S、R、L”三大类型,而华天科技eSinC 2.5D封装技术平台中的SiCS、FoCS则分别对标CoWoS的“S、R”两大技术分类,性能优异。
AI助推先进封装市况
先进封装市况大好,产业巨头纷纷扩张——台积电在多地挤出厂房空间增充CoWoS产能,甚至为应对溢出的先进封装产能,还委外给日月光承接相关订单;英特尔副总裁兼亚太区总经理Steven Long则表示,该公司正在马来西亚槟城兴建最新的封装厂,强化2.5D/3D封装布局;安靠(Amkor)在去年12月宣布斥资20亿美元在美国亚利桑那州建造先进封装厂。
华天科技也不例外。目前,华天科技在全球总计拥有9座工厂,分别是天水、西安、江苏、南京、昆山、上海、韶关、成都、马来西亚,面向不同领域布局先进技术。2024年,华天科技坚持以市场为导向的技术创新,持续进行先进封装技术和产品的研发以及量产工作,加快 2.5D、FOPLP 封测量产能力建设:
3月28日,华天科技南京公司成立南京工厂二期项目,总投资100亿元,拟新建20万平方米的厂房及配套设施,新增工艺设备5000台/套,打造先进封测基地,产品将主要应用于存储、射频、算力(AI)、自动驾驶等。华天科技透露:“在南京按照fab标准布局2.5D专用厂房,设备将在今年下半年陆续到厂,年底完成调试,给客户提供打样服务。”

6月30日,江苏盘古半导体科技股份有限公司多芯片高密度板级扇出型封装产业化项目奠基仪式举行。这是华天科技2018年落户以来,在南京布局的第四个重量级产业项目,将聚焦板级封装技术的开发及应用,建设世界首条全自动板级封装生产线。
中信证券研究消息称,随着下游需求逐步回升,半导体行业增速回到2021年周期启动前水平,传统封装有望进入复苏通道;此外,先进封装在AI时代增量需求及国产替代空间巨大。
华天科技7月13日公布的《2024年半年度业绩预告》也印证了上述观点:上半年盈利1.9亿-2.3亿元,净利润同比预增202.17%—265.78%。公告表示,报告期内,公司订单增加,产能利用率提高,营业收入较去年同期有显著增长,从而使得公司经营业绩大幅提高。

VIP课程推荐
APP专享直播
热门推荐
收起
24小时滚动播报最新的财经资讯和视频,更多粉丝福利扫描二维码关注(sinafinance)







